最新消息
封裝技術與ABF需求
2022-05-19
封裝技術與ABF需求
先進封裝,突破摩爾定律瓶頸,降低晶片製造成本;小晶片Chiplet提升了晶片的良率、靈活度,也同時降低了晶片生產成本;FCBGA以優異的性能吉成本優至,穩居封裝主流技術。
摩爾定律:積體電路上的電晶體數目,約每隔18個月便會增加一倍,效能也會提高一倍。
 |
世界級晶圓代工龍頭,台積電與Intel皆各自推出不同型態的晶片,為各自的3D封裝進行布局;台積電,整合InFO與CoWoS,以混合封裝架構,推出系統整合晶片SoIC;Intel則以Face-to-Face的鍵合形式,推出Foveros。
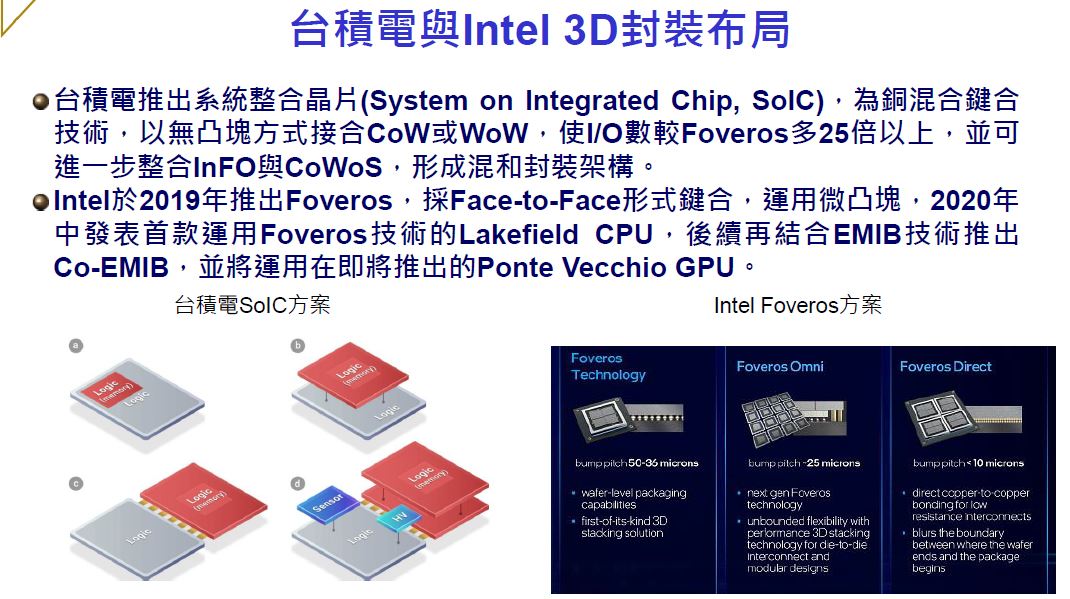 |
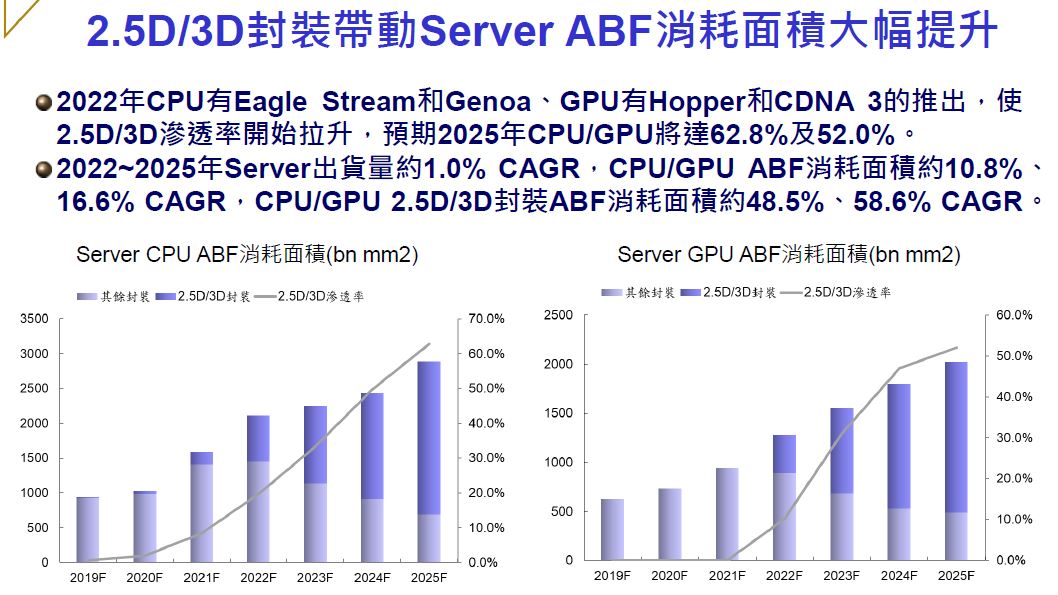 |
 |
而3D封裝的需求,同步帶動PCABF的消耗,但礙於前期投入廠商為少數,故2021年的供需缺口達到30%,預計此供需缺口會持續至2025年,在此產業的相關載板個股包含:欣興(3037)、南電(8046)、景碩(3189)、臻鼎-KY(4958),可以陸續關注這幾檔股票。
參考資料來源:兆豐國際投顧<台灣科技產業專題-PCB產業>文章
駿康科技刊載之最新消息內容僅做為參考,請投資人於投資前多考量投資需求與風險,本公司恕不負擔任何法律責任。

